半导体|半导体制造关键工艺装备CMP:全球双寡头格局,国产装备崛起
概述:? CMP 设备是半导体制造的关键工艺装备之一。CMP 是集成电路制造大生产上产出效率最高、技术最成熟、应用最广泛的纳米级全局平坦化表面制造设备,并且在较长时间内不存在技术迭代周期。而且随着芯片制造技术发展,CMP 工艺在集成电路生产流程中的应用次数逐步增加,将进一步增加 CMP 设备的需求。根据 SEMI,2018 年全球 CMP设备的市场规模 18.42 亿美元,约占晶圆制造设备 4%的市场份额,其中中国大陆 CMP 设备市场规模 4.59 亿美元。另外,CMP 设备是使用耗材较多、核心部件有定期维保更新需求的制造设备之一;除了用于晶圆制造,CMP 还是晶圆再生工艺的核心设备之一,CMP 设备厂商有望向上游耗材、下游服务领域延伸。
? 全球双寡头格局,国产装备崛起。根据 Gartner 数据,2017 年美国应用材料和日本荏原两家公司合计占有全球 90%以上市场份额。国内CMP 市场,目前在高端市场部分,绝大部分仍然依赖于进口,在 14nm以下最先进制程工艺的大生产线上所应用的 CMP 设备仅由美国应用材料和日本荏原两家国际巨头提供。应用材料与日本荏原分别已实现5nm 制程和部分材质 5nm 制程的工艺应用;但是在成熟制程领域,以华海清科为代表的国内企业已经打破了国外巨头常年垄断的局面,并且已经在国内 CMP 市场占据了重要份额。
一、CMP:“小而美”的半导体关键工艺装备(一)CMP 设备是半导体制造的关键工艺装备之一
CMP(Chemical Mechanical Polishing,化学机械抛光)是半导体制造过程中实现晶圆全局均匀平坦化的关键工艺。晶圆制造过程主要包括7个相互独立的工艺流程:光刻、刻蚀、薄膜生长、扩散、离子注入、化学机械抛光、金属化。作为晶圆制造的关键制程工艺之一,化学机械抛光指的是,通过化学腐蚀与机械研磨的协同配合作用,实现晶圆表面多余材料的高效去除与全局纳米级平坦化。
由于目前集成电路元件普遍采用多层立体布线,集成电路制造的前道工艺环节需要进行多层循环。在此过程中,需要通过CMP工艺实现晶圆表面的平坦化。简单的理解,如果把芯片制造过程比作建造高层楼房,每搭建一层楼都需要让楼层足够平坦齐整,才能在其上方继续搭建另一层,否则楼面就会高低不平,影响整体性能和可靠性。而CMP就是能有效令集成电路的“楼层”达到纳米级全局平整的一种关键工艺技术。集成电路制造是CMP设备应用的最主要的场景,重复使用在薄膜沉积后、光刻环节之前;除了集成电路制造,CMP设备还可以用于硅片制造环节与先进封装领域。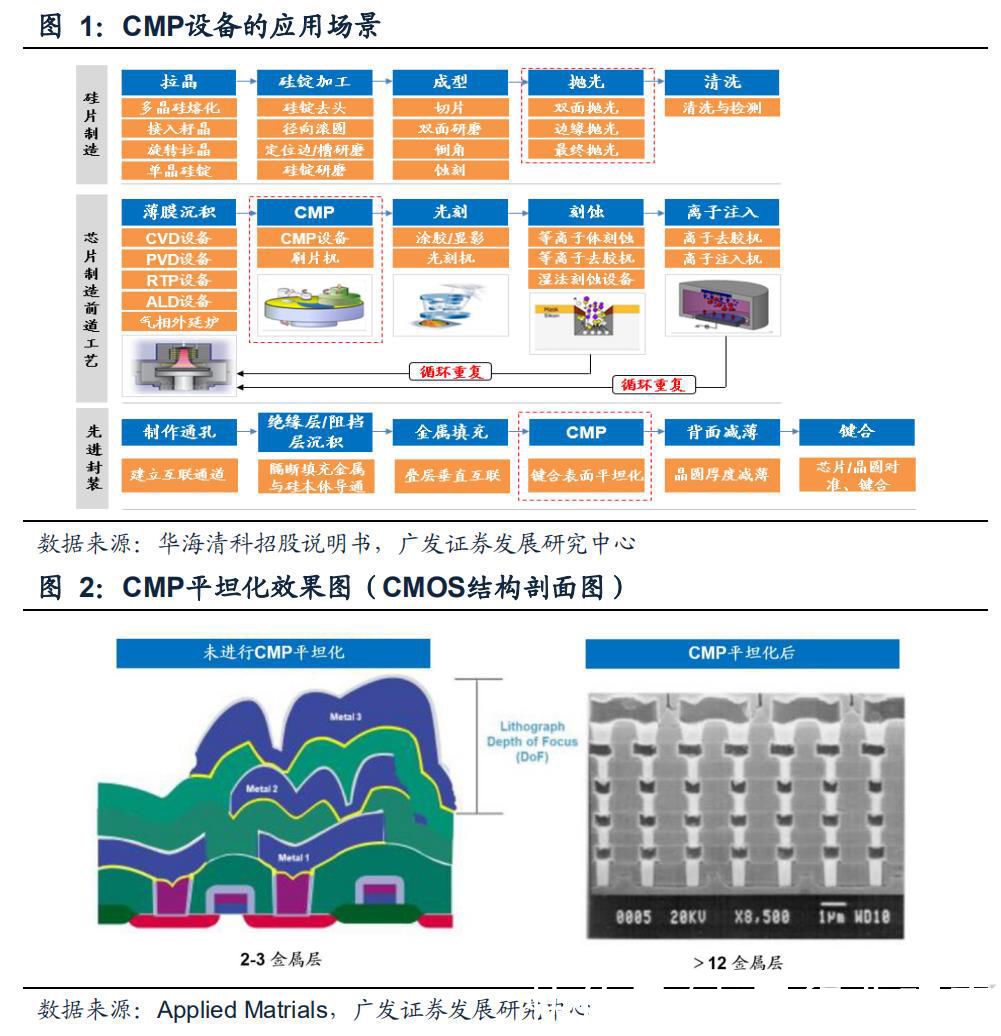
文章插图
当前CMP已经广泛应用于集成电路制造中对各种材料的高精度抛光。按照被抛光的材料类型,具体可以划分为三大类:(1)衬底:主要是硅材料。(2)金属:包括Al/Cu金属互联层,Ta/Ti/TiN/TiNxCy等扩散阻挡层、粘附层。(3)介质:包括SiO2/BPSG/PSG等ILD(层间介质),SI3N4/SiOxNy等钝化层、阻挡层。其中,在90~65nm节点,浅槽隔离(STI)、绝缘膜、铜互连层是CMP的主要研磨对象;进入28nm后,逻辑器件的晶体管中引入高k金属栅结构(HKMG),因而同时引入了两个关键的平坦化应用,包括虚拟栅开口CMP工艺和替代金属栅CMP工艺。
文章插图
STI-CMP:浅槽隔离(STI)氧化硅抛光。在硅晶片上以反应性蚀刻形成沟槽后,以化学气相沉积的方式沉积二氧化硅膜再将未被埋入凹沟内的二氧化硅膜以CMP去除。这样就可以用二氧化硅膜作为元器件间的隔离,再用抛光速度相对缓慢的膜(例如氮化硅膜)来作为CMP的研磨停止层(Stoplayer)。
- 酷睿处理器|关键数据出炉,京东比阿里差远了
- CPU|元宇宙+高端制造+人工智能!公司已投高科技超100亿,股价仅3元
- 智能制造|企业转型的新时代,夹缝中求生存
- 央媒表态后,联想关键数据出炉,柳传志这回要扳回一局?
- 阿里巴巴|被苹果无辜“踢出局”,引发央视点名,国产制造该何去何从?
- 芯片|又一巨头或对英特尔“下手”,美方希望重掌芯片制造,机会渺茫!
- 中国半导体产业进入了技术驱动成长期 半导体及元件板块短线拉升|板块异动 | 拉升
- 大众网·海报新闻记者 单姗 单文玲 潍坊报道为助力企业健康快速成长|“小巨人”华特磁电“磁”实发展 跑出潍坊制造业加速度
- 产业链|航空装备制造行业产业链全景梳理及区域热力地图
- 芯片|全球仅有,能设计并制造出5nm芯片的,不是苹果更不是台积电
