半导体|半导体制造关键工艺装备CMP:全球双寡头格局,国产装备崛起( 三 )
(2)辅助、控制技术。具体包括纳米级的清洗、膜厚在线检测、智能化控制等,这些是实现CMP工艺的重要的辅助技术,作用在于晶圆抛光动作“停得准”、以及抛光后纳米颗粒“洗得净”。根据赛迪顾问相关资料,通常CMP工艺后的器件材料损耗要小于整个器件厚度的10%,也就是说CMP不仅要使材料被有效去除,还要能够精准的控制去除速率和最终效果。随着器件特征尺寸的不断缩小,缺陷对于工艺控制和最终良率的影响愈发明显,降低缺陷是CMP工艺的核心技术要求,因而当前对CMP设备而言,除了抛光技术,包括清洗技术、工艺控制技术等辅助类技术的重要性愈发突出。
文章插图
抛光:在CMP发展过程中,CMP逐步由最初的单头、双头向着多头方向发展;抛光结构方面,目前处于轨道抛光方法、线性抛光、与旋转结构抛光并存状态,其中旋转结构占据主流;在抛光驱动技术方面,早年国际厂商普遍采用皮带传动方式,当前随着客户要求提高以及电机技术发展,直驱式已成为高端机型的主要驱动方式。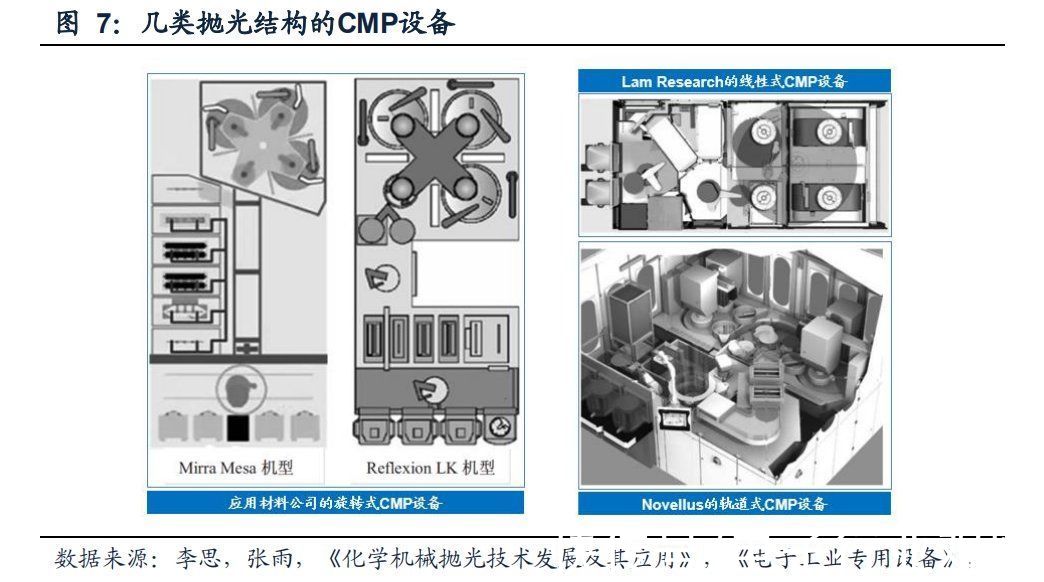
文章插图
终点检测:要检测抛光的终点,需要实时得到被抛光薄膜的厚度。CMP的终点判断就是判断何时到达CMP的理想终点,从而停止抛光。在结构微细化、高精度要求下,晶圆膜厚要求精度控制在0.1nm,些许偏差都将对薄膜的力学性质、光学性质以及器件的设计以及可靠性产生重要影响。准确的终点监测是产品成品率、加工效率的关键技术,直接影响到成本与市场竞争力。
根据终点检测的特点可以分为基于时间的离线终点检测技术和实时在线检测技术,其中基于时间的离线终点检测技术主要应用在直径小于200mm的晶圆加工中。在线终点检测技术主要包括电机电流终点检测、光学终点检测和电涡流终点检测,另外包括基于抛光液离子浓度变化的终点检测、基于声学发射信号的终点检测和基于机械力学信号测量的终点检测也是当时CMP在线监测的热点。其中电机电流终点检测是包括应用材料、日本荏原等国际巨头采用的主要终点检测技术。
电极电流终点检测:其原理是当晶圆抛光达到终点时,抛光垫所接触的薄膜材料不同,导致晶圆与抛光垫之间的摩擦系数发生显著变化,从而使抛光头或抛光机台回转扭力变化,其驱动电机的电流也随之变化,因此由安装在抛光头和抛光机台上的传感器监测驱动电机电流变化可推知是否到达抛光终点。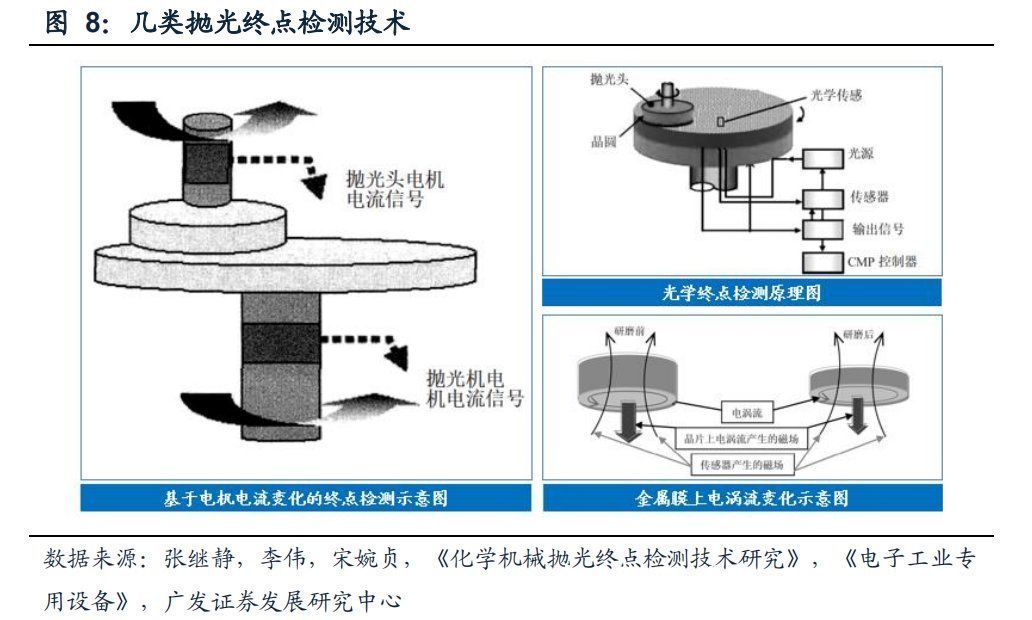
文章插图
CMP后清洗:在CMP工艺中,抛光液中的磨料和被去除的材料作为外来颗粒(含金属颗粒)是CMP工艺的污染源,CMP后清洗的重点是去除抛光过程中带有的所有污染物。当前CMP机台已经把CMP工艺和清洗工艺集成在一起,而且要求干进干出,包含清洗与干燥两大环节。随着晶圆表面洁净度要求的不断提高,CMP清洗工艺的焦点已逐步由清洗液、兆声波等转移到晶圆干燥上。
文章插图
第1代CMP后清洗技术:该阶段半导体CMP设备市场初步形成,市场主要设备包括Strasbaugh公司的6DS-SP以及Westech的PEC372/372M。这时期的CMP后清洗,主要是抛光后再将整盒的晶圆提出来放置到单独的清洗机进行清洗,采用多槽浸泡化学湿法清洗技术,主要应用于较大线宽的集成电路,而且清洗时间较长,一般都会大于1个小时,与CMP衔接性能也较差。
第2代CMP后清洗技术:代表设备是应用材料的适用于8英寸的Mirra。Mirra采用在线清洗系统,清洗仍然是在单独的清洗机台中完成,不过Mirra和清洗机台之间有机械接口和传输装置,CMP作为主机直接调度清洗机台菜单,来完成CMP后清洗。
- 酷睿处理器|关键数据出炉,京东比阿里差远了
- CPU|元宇宙+高端制造+人工智能!公司已投高科技超100亿,股价仅3元
- 智能制造|企业转型的新时代,夹缝中求生存
- 央媒表态后,联想关键数据出炉,柳传志这回要扳回一局?
- 阿里巴巴|被苹果无辜“踢出局”,引发央视点名,国产制造该何去何从?
- 芯片|又一巨头或对英特尔“下手”,美方希望重掌芯片制造,机会渺茫!
- 中国半导体产业进入了技术驱动成长期 半导体及元件板块短线拉升|板块异动 | 拉升
- 大众网·海报新闻记者 单姗 单文玲 潍坊报道为助力企业健康快速成长|“小巨人”华特磁电“磁”实发展 跑出潍坊制造业加速度
- 产业链|航空装备制造行业产业链全景梳理及区域热力地图
- 芯片|全球仅有,能设计并制造出5nm芯片的,不是苹果更不是台积电
